SiC JFET在固态断路器中的四大优势详解
本文详细介绍了SiC JFET在固态断路器中的应用,重点讨论了其低导通电阻、小封装尺寸、高可靠性和易于使用等优势。通过对比和实际测试结果,展示了SiC JFET在电路保护系统中的重要性。
关于「半导体与集成电路」的技术文章、设计资料与工程师讨论,持续更新。
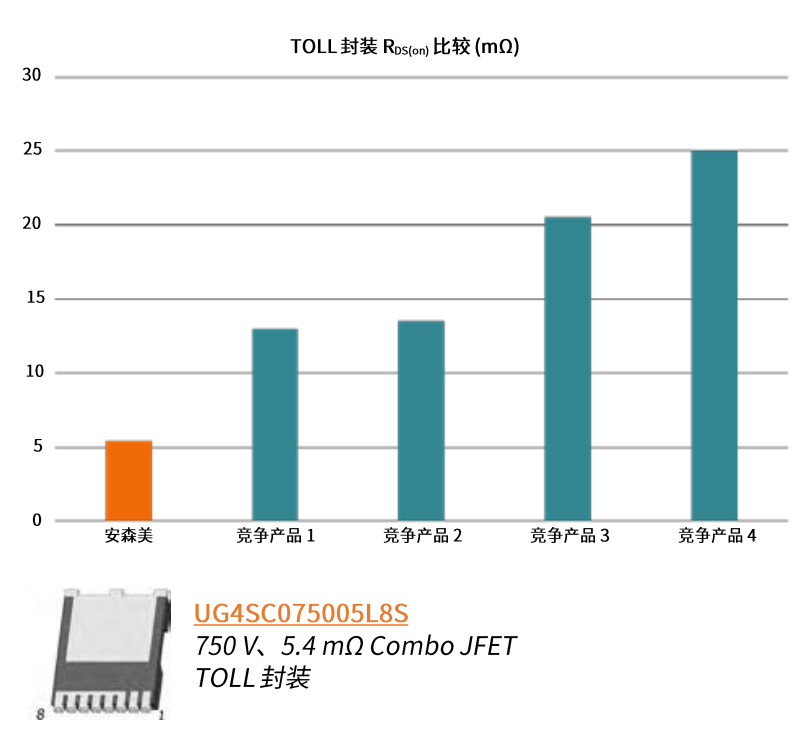
本文详细介绍了SiC JFET在固态断路器中的应用,重点讨论了其低导通电阻、小封装尺寸、高可靠性和易于使用等优势。通过对比和实际测试结果,展示了SiC JFET在电路保护系统中的重要性。
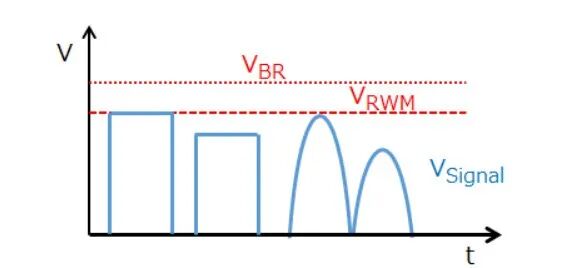
本文详细介绍了TVS二极管的实战选型指南和布局技巧,包括选择合适的反向击穿电压、动态电阻和钳位电压等关键参数,以及如何在电路中合理布局以最大化保护效果。

本文详细介绍了SiC JFET在固态断路器中的应用,包括评估结果、热插拔控制及浪涌电流限制。通过实验数据和图表展示了SiC JFET的性能优势。

意法半导体推出的TSZ901运算放大器具有高精度、零漂移和10MHz增益带宽积,适用于多种高精度应用。该产品在-40°C至125°C的工作温度范围内表现出色,符合AEC-Q100标准。
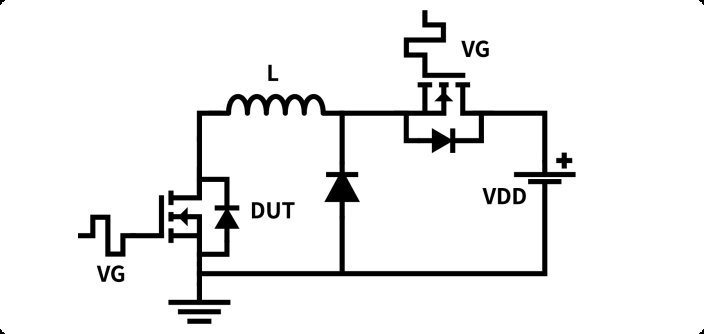
本文详细解析了功率MOSFET器件的单脉冲雪崩能量(EAS)参数,包括其定义、重要性、测试方法及影响因素,并探讨了EAS失效模式和电路保护措施。

Wolfspeed最新推出TOLT封装650V第四代MOSFET,为AI数据中心等高要求应用提供先进的碳化硅解决方案,具备更优异的散热管理和更高的可靠性。
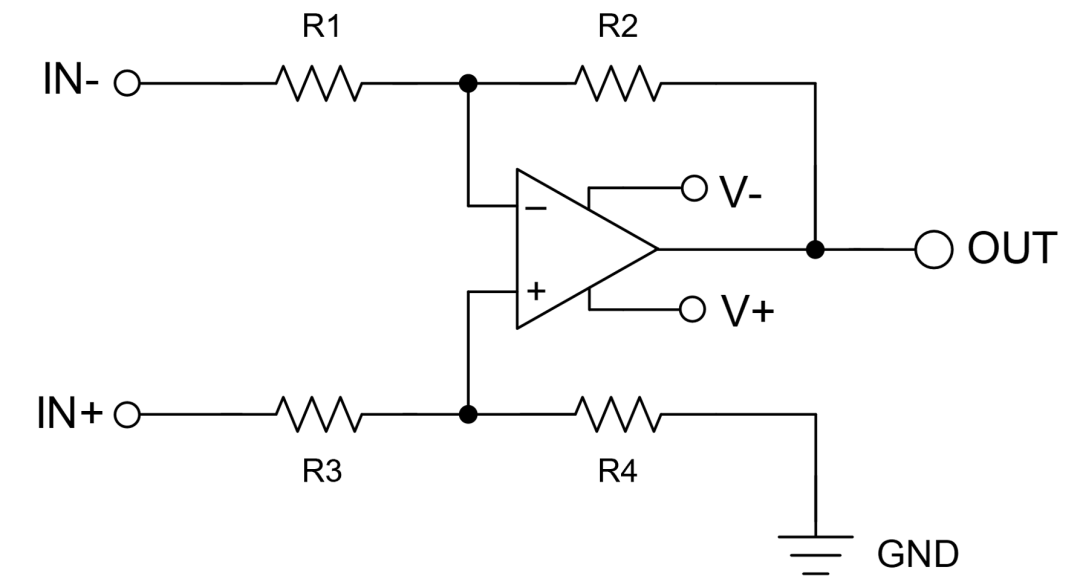
本文对比了分立式与集成式差分放大器的性能,通过实测数据(包括偏移电压、共模抑制比 [CMRR]、增益误差及增益误差温漂)对两种方案进行了详细分析。

本文介绍了Samtec的玻璃芯技术(GCT),该技术在5G和先进数字计算领域具有广泛应用。文章详细解析了GCT的优势、应用案例及关键技术要点。

燧原科技和曦智科技在2025世界人工智能大会上推出国内首款xPU-CPO光电共封芯片,采用CPO技术,实现了40%的通信密度增加,为数据中心光互连树立新标杆。

中芯国际2025年第二季度财报显示,销售收入为22.09亿美元,环比下降1.7%,毛利率为20.4%。上半年销售收入同比增长22%,毛利率提升7.6个百分点。

中微公司在CSEAC 2025上发布了六款新的半导体设备,包括等离子体刻蚀、原子层沉积和外延设备,展示了其在高端半导体设备市场的领先地位。

三星宣布Exynos 2600将成为全球首款采用2nm工艺的移动SoC,该芯片已完成开发并准备量产。Exynos 2600采用1+3+6核心设计,并配备新型散热部件。

美国商务部将复旦微电子列入实体清单(Footnote 4),限制其获取美国技术。复旦微电子表示已构建可持续发展格局,加强战略储备,确保供应链稳定。

芯和半导体凭借自主研发的3DIC Chiplet先进封装仿真平台Metis,荣获第二十五届中国国际工业博览会CIIF大奖,成为首个获此殊荣的国产EDA企业。

英飞凌与罗姆达成碳化硅功率器件封装合作协议,双方将互为第二供应商,提升设计与采购灵活性。

合肥晶合集成向香港联交所递交招股书,成为全球第九大、中国大陆第三大晶圆代工企业。公司专注于显示驱动芯片和CMOS图像传感器的研发与制造,预计未来市场将持续增长。

台积电2025年第三季度财报显示,净利润创纪录新高。英伟达或取代苹果成为台积电最大客户,AI基础设施需求推动高性能计算芯片收入增长。

清华大学和北京大学分别在智能光子技术和模拟矩阵计算芯片领域取得重大突破,标志着我国在高精度成像测量和大规模MIMO信号检测方面迈上新台阶。

中国蚌埠传感谷的8英寸MEMS晶圆全自动生产线正式投产,总投资50.6亿元,月产能达3万片,标志着国内领先的MEMS晶圆代工企业正式运营。
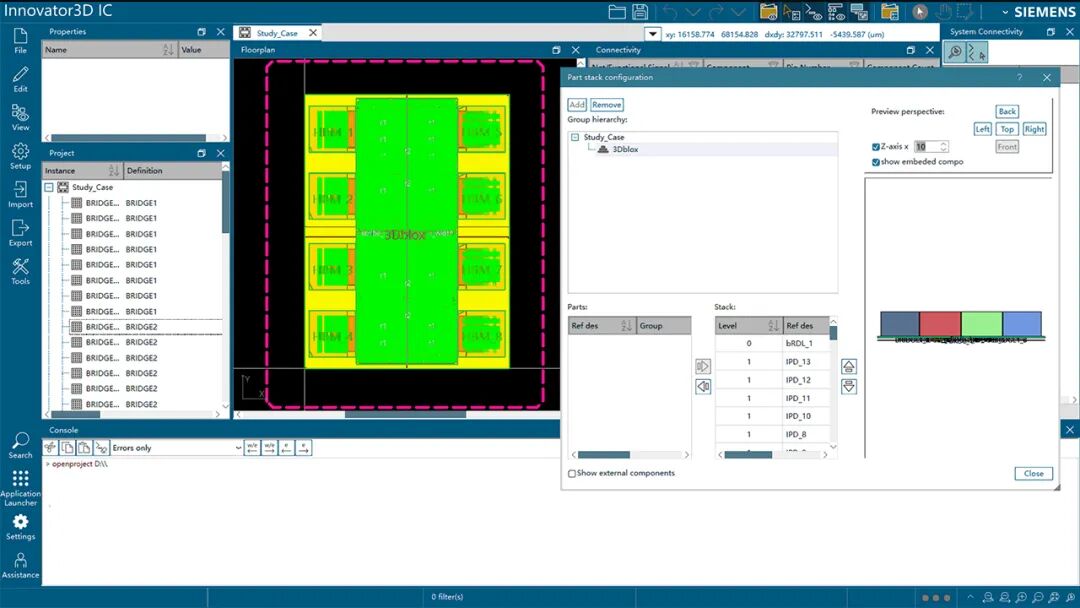
西门子数字化工业软件与日月光集团合作,开发基于3Dblox的VIPack先进封装平台工作流程,已完成三项技术验证。