T2PAK封装为SiC
功率芯片带来的优势
电动汽车(EV)、可再生能源系统和人工智能数据中心等电气化进程的加速,给电力系统带来了越来越大的压力,要求更高的效率、更小的尺寸和更低的运行温度。这带来了一个始终存在的挑战:功率密度的提高和系统尺寸的缩小往往会造成严重的散热瓶颈。本文将为您分析SiC功率芯片所面临的挑战,以及安森美(onsemi)提供的T2PAK封装将为功率芯片带来哪些优势。
新型封装解决方案能够
提供有效的散热管理和更高的效率

想要解决当今电力系统设计人员所面临的效率、尺寸和温度上的挑战,有效散热已成为一项关键的设计难题。全球市场正在加速采用碳化硅(SiC)技术,但散热设计常常是一个限制因素。传统的封装解决方案通常难以满足高功率SiC应用的散热需求,因此需要在开关性能和散热效率之间做出权衡。新型封装解决方案能够为当今要求更高的应用,提供有效的散热管理和更高的效率。
当前电子产品正面临许多电气化的挑战,配电板通常已经承受过大的压力,往往已达到其最大热极限,工程师无法承受功率开关产生的过剩热量转移到这些电路板上。其中D2PAK(TO-263-7L)和TO-247-4L是两种因其相对较高的散热性能而广为人知的MOSFET封装,但在空间受限的情况下,它们的缺点显而易见。
TO-247-4L的散热性能尚可,因为它可以通过简单的螺丝夹轻松连接到散热器,从而留出足够的散热路径。但在狭小的空间内,其附近的引脚、导电走线和电容器可能会形成较大的换向环路,这会是所有寄生电感的总和,可能导致过冲较大、开关速度降低和开关损耗增加。
D2PAK可以有效缓解寄生电感问题,因为作为一种表面贴装器件(SMD),其较短的铜走线最大限度地减少了换向环路的面积。与TO-247-4L相比,D2PAK封装确实能够实现更快的开关速度。然而,D2PAK必须通过印刷电路板(PCB)散热,导致散热器与器件之间的热阻更大。
设计人员需要一种能够克服这些缺点,同时又不牺牲性能或增加系统尺寸的解决方案,而T2PAK封装就此应运而生。T2PAK结合了安森美业界领先的碳化硅技术和应用最广泛的顶部冷却(TSC)封装形式之一,T2PAK的独特设计兼顾了卓越的散热性能和出色的开关性能,融合了TO-247-4L和D2PAK的优势,且无明显缺点。
T2PAK的顶部散热技术实现MOSFET
与散热器之间的直接热耦合
顶部散热(TSC)技术实现了SMD封装中,MOSFET与应用散热器之间的直接热耦合,这使得热量能够从配电板直接传递到系统的散热系统或金属外壳,从而绕过了D2PAK封装中常见的PCB散热瓶颈。
T2PAK封装的顶部散热技术优势包括具有卓越的散热性能,可将热量直接传递到散热器,以降低环境工作温度,并可降低热压力,将热量从主板导出可降低其他元器件的热压力,有助于保持较低的PCB温度,同时延长使用寿命并提高系统可靠性。T2PAK封装可提供低杂散电感,诸如安森美的NTT2023N065M3S和NVT2023N065M3S等高性能开关器件,都具有极低的总栅极电荷(≈74 nC)和输出电容(≈195 pF),从而具有更高的可靠性和更低的损耗。
此外,EliteSiC出色的品质因数(FOM)与顶部冷却的T2PAK封装相结合,可实现更高效、更小尺寸的应用设计,提供设计灵活性。T2PAK产品组合提供多种选择,包括计划推出的650 V和950 V EliteSiC M3S MOSFET的12 mΩ、16 mΩ、23 mΩ、32 mΩ、45 mΩ和60 mΩ阻值。
T2PAK封装可符合IEC 60664-1爬电距离标准,即两个导电部件之间沿绝缘材料表面的最短距离(最小5.6 mm),12 mΩ器件的结壳热阻低至0.35 ℃/W(优于D2PAK),并兼容液隙填充剂、焊盘和陶瓷绝缘体,可优化散热堆叠,提供安装灵活性。
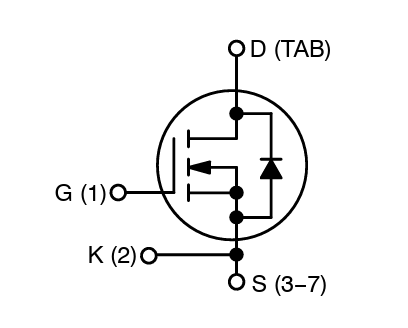
SiC MOSFET T2PAK的引脚图
T2PAK封装非常适合要求严苛的
工业和汽车应用
T2PAK的全球样品测试已于2025年在欧洲、美洲和大中华区展开,该封装非常适合要求严苛的工业和汽车应用。在电动汽车应用中,T2PAK封装通常是车载充电器(OBC)、动力传动系统元器件和电动汽车充电站中最受欢迎的封装。由于OBC通常需要接入车辆的液冷系统,TSC封装能够通过导热界面将功率开关产生的热量导入系统。降低杂散电感可以提高功率效率,因为消除换向环路问题可以降低开关损耗。此外,符合IEC爬电标准有助于加强制造商对客户的安全承诺。
在工业和能源基础设施应用中,由于TSC封装卓越的热效率,使其在太阳能系统中迅速占据一席之地。T2PAK封装已被证明是新型先进基础设施应用,像是太阳能转换和储能系统(ESS)的理想之选。
另一方面,超大规模人工智能数据中心依赖于机架式AC-DC和DC-DC电源以及配电单元,整个超大规模架构都围绕着这些电源单元的便捷访问和更换而构建。随着液冷在数据中心的普及,T2PAK封装的原生顶部冷却功能与冷板设计完美契合。在这种设计中,自由流动的冷却液在与热界面直接连接的通道内循环,将热量从高性能处理器中带走。根据最近的一项研究,冷板设计与浸没式冷却相结合,可将温室气体排放量减少多达五分之一。
通过克服散热挑战,T2PAK封装使设计人员能够实现更高的性能、更强的可靠性和更简化的散热管理。与传统的独立封装相比,客户可以使用T2PAK实现更高的功率密度。
T2PAK还适用于高压DC/DC转换器(汽车和工业)、用于自动化和机器人的工业开关电源(SMPS)、工业驱动器和高效DC-DC转换器。随着电力系统的不断发展,未来的设计将越来越依赖于顶部冷却,以满足严格的效率和尺寸目标。安森美已做好准备,将领先的SiC技术与T2PAK封装相结合,引领行业发展。
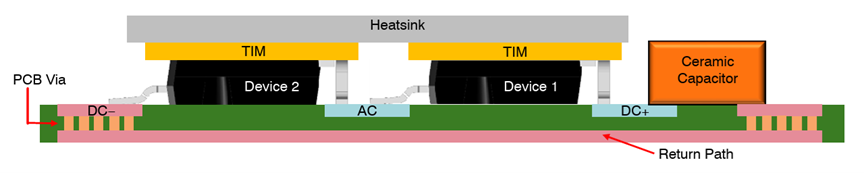
专为汽车和工业高压应用设计的
顶部冷却封装
为了增强安森美先进的功率封装产品组合,安森美推出了T2PAK和BPAK封装,这两款顶部冷却封装旨在满足汽车和工业高压(HV)应用的严格标准。与需要通过印刷电路板提取功率的底部冷却封装(例如D2PAK和TOLL)不同,T2PAK和BPAK采用顶部冷却设计,这种设计确保与散热器直接接触,从而显着提高散热性能。
凭借顶部冷却和无引线设计,T2PAK通过消除长引线并实现比D2PAK或TO封装更小的电流环路,最大限度地减少了杂散电感。这带来了更佳的开关特性、更低的电压过冲和更好的电磁兼容性(EMC)性能,使T2PAK成为紧凑型、高效功率设计的理想之选。这一进步实现了更高的功率密度,满足了高性能应用不断变化的需求。安森美在这种新型封装中,首批推出的产品包括八款Elite-SiC 碳化硅MOSFET,涵盖T2PAK汽车级认证产品,像是采用M3S与M2技术的650 V与950 V / 900 V产品线,以及T2PAK工业级认证产品,涵盖采用M3S技术的650 V产品线。
T2PAK和D2PAK(TO-263)封装均为高功率表面贴装解决方案,专为紧凑型PCB布局中的高效散热而设计。虽然它们的电气尺寸相似,但散热架构却截然不同。D2PAK是一种底部散热封装,依靠裸露的漏极焊盘将热量传递到PCB铜层,并通过导热过孔传递到内部或背面的铜层。相比之下,T2PAK引入了顶部散热功能,通过集成的通孔连接片,可以直接连接到外部散热器或金属机箱。这种顶部散热路径提供了更高效、更可控的散热机制,尤其适用于PCB散热能力有限或器件侧有强制风冷的应用。
相比之下,底部散热封装依靠PCB的底部铜层进行散热,这限制了其在电气布线方面的应用。这种限制使得紧凑型换向环路的实现变得困难,通常会导致更长的走线路径和更高的寄生电感。由于底层必须用于散热(通常通过散热过孔和大面积铜箔),因此将回流路径紧贴功率环路布线变得不切实际。这会导致磁通抵消效率降低和环路电感升高,从而对开关性能产生负面影响。在这方面,顶部冷却封装(例如T2PAK)比底部冷却封装具有明显的优势。它们的散热设计允许更灵活的电气布线,从而实现更紧凑、更优化的换向环路。
这种架构差异转化为可衡量的散热性能提升。对于32 mΩ器件,T2PAK的结到外壳热阻为0.7 ℃/W,略优于D2PAK的0.75 ℃/W。对于低电阻、高电流器件,这种优势更为显着,像是12 mΩ T2PAK器件的温升为0.3 ℃/W,而其对应的D2PAK器件的温升为0.35 ℃/W。这些改进主要归功于T2PAK能够将热量直接传递到散热器,从而绕过PCB的散热限制。因此,T2PAK特别适用于对散热有严格要求的设计或需要更大散热空间的应用环境,例如汽车电源模块、工业驱动器和高效DC-DC转换器。
与传统的SMD器件相比,顶部冷却封装通常具有更优异的散热性能,这是因为其能够直接从裸露的金属焊盘(MOSFET的漏极、IGBT的集电极、整流器的阴极)导出热量,而无需像底部冷却封装那样受到中间PCB材料的热阻影响。T2PAK封装凭借其顶部冷却能力,能够直接与散热器或冷板接触,从而克服了底部冷却SMD封装(如TO-263-7)中基于PCB的热传递限制,具有显着的散热优势。
T2PAK封装设计用于回流焊工艺,并安装到PCB板上。该封装遵循IPC/JEDEC J-STD-020E回流焊曲线。T2PAK封装兼容锡铅(Sn-Pb)和无铅(Pb-Free)两种焊接工艺,但每种工艺所需的热曲线各不相同。锡铅焊接工艺使用熔点较低的共晶焊料合金(183℃),而无铅焊接工艺(通常使用SAC305合金)则需要较高的液相线温度(217℃)和高达245℃的回流焊峰值温度。适当的预热和温度控制至关重要,尤其对于无铅焊工艺而言,以最大限度地减少热压力并确保焊点的可靠性。
结语
随着电气化重塑各行各业,安森美的EliteSiC T2PAK正在重新定义高效电源转换的可能性。采用T2PAK TSC封装的EliteSiC MOSFET代表着封装技术的进步,是推动电气化的战略性因素。T2PAK提供卓越的散热性能、可靠性和设计灵活性,且无需做出常见的权衡取舍,从而克服了全球各行业面临的空间和散热限制。安森美的T2PAK芯片面向广大市场发售,将可确保这项关键技术得到广泛应用。

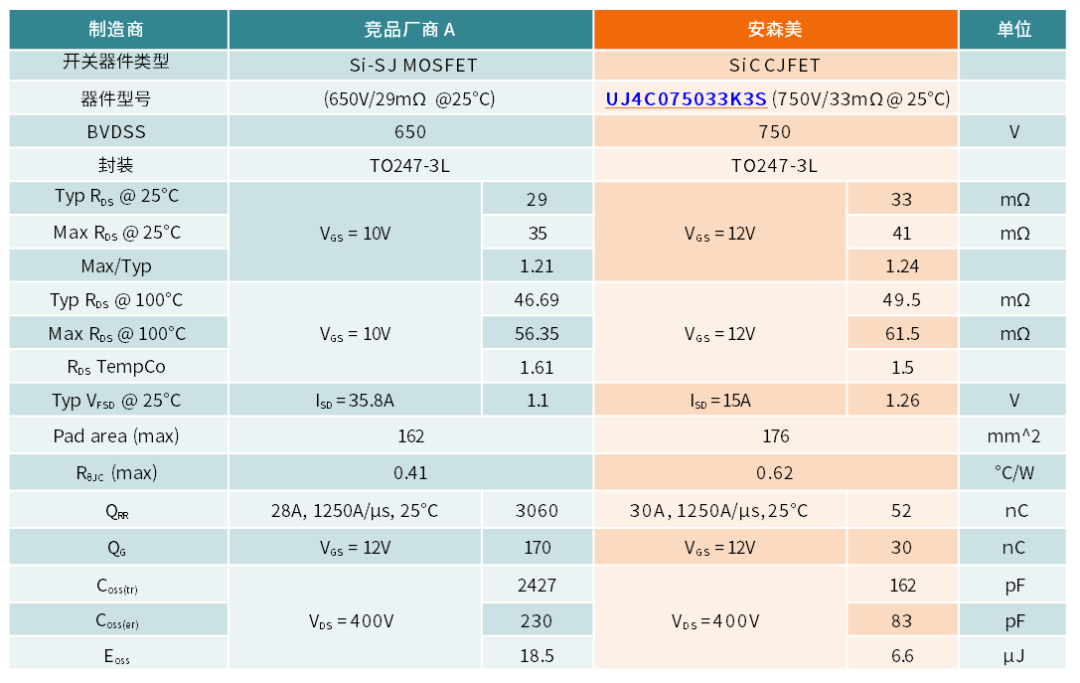




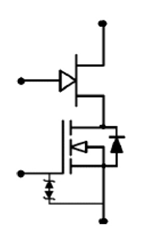

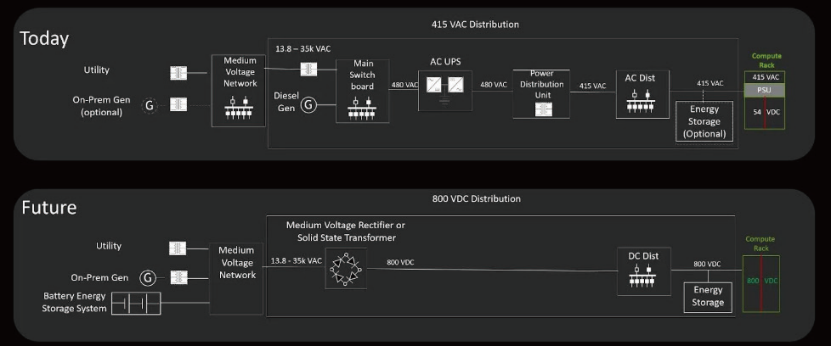


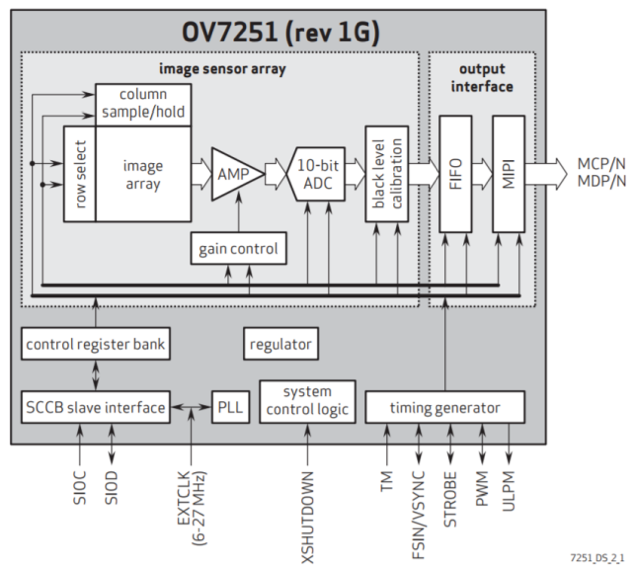



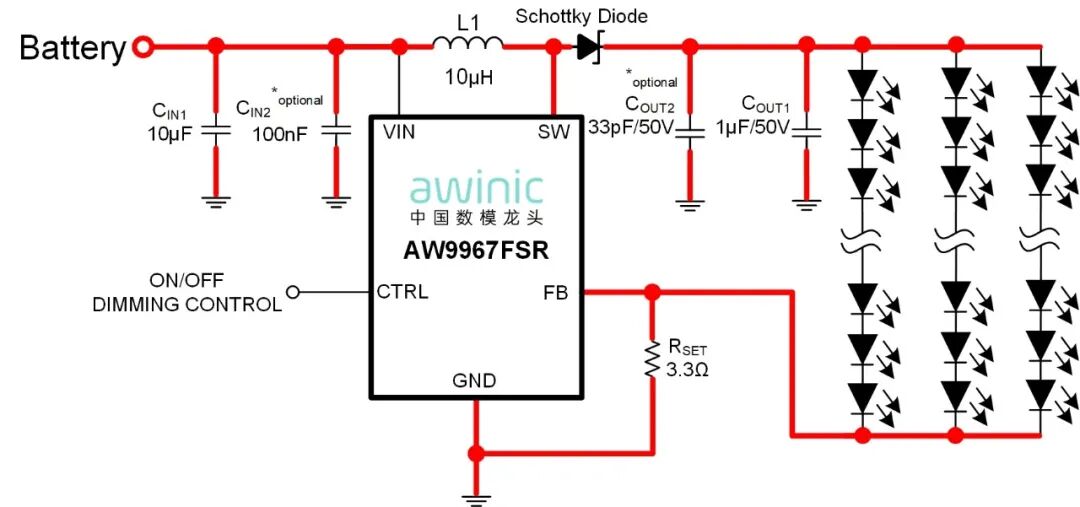



评论区
登录后即可参与讨论
立即登录