湿法腐蚀的侧蚀能“根治”吗?结论是:常规湿法侧蚀本质难除,但特定工艺下可控。若追求零侧蚀,则必须转向干法刻蚀。
一个干脆的结论:在绝大多数常规工艺中,湿法腐蚀的侧蚀(Undercut)无法完全消除,只能尽可能去控制和补偿。如果工艺要求绝对的“零侧蚀”(即完美的90度垂直侧壁),通常只能放弃湿法,改用干法刻蚀。
这主要是由湿法腐蚀的化学本质决定的。

为什么常规湿法生来带有侧蚀
常规的湿法腐蚀属于各向同性腐蚀。
纯化学反应是没有“方向感”的。当刻蚀液接触到暴露的材料表面时,它向下腐蚀的速度与向左右两侧腐蚀的速度几乎是一样的(横向与纵向刻蚀速率比通常接近 1:1)。
当药液透过光刻胶的开口向下刻蚀,终于到底的时候,实际上药液也已经在光刻胶下方“掏出”了相同距离的侧壁。
唯一的例外:各向异性湿法腐蚀
在湿法工艺中,唯一能做到严格控制侧壁形状、甚至消除传统意义上“圆弧形侧蚀”的,是利用晶体材料自身的晶格特性进行各向异性腐蚀。
典型案例:单晶硅在 KOH 或 TMAH 中的腐蚀。
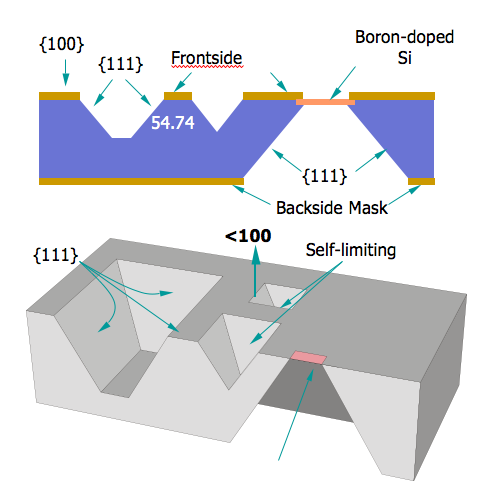
硅的原子结构中,(111) 晶面的原子排列最紧密、键能最高。KOH 药液在 (100) 晶面上的刻蚀速度极快,但在 (111) 晶面上几乎啃不动(速率相差可达几百倍)。
结果:刻蚀会沿着 (100) 面快速向下,一旦遇到 (111) 面就会自动停止,最终形成一个极其平整的 54.74° 的 V型槽或斜坡结构。虽然这不是90度垂直,但它的侧壁是极其精准和可控的,这在 MEMS 制程中非常经典。
产线上如何把侧蚀的影响降到最低
1,掩膜尺寸补偿
这是最常用的手段。既然知道线条会被咬窄,就在设计光刻版图时,故意把保留的线条做宽(或者把刻蚀开口做窄)。
2,防过刻(Over-etch)控制
为了保证大面积晶圆上每个区域都刻透,通常会增加 10%~20% 的过刻时间。过刻时间越长,侧蚀越严重。为了卡准终点,使用单片清洗/湿法设备会比传统的槽式设备更有优势,因为单片机台能在刻蚀达到终点的瞬间,立刻用去离子水强力冲洗,切断反应,避免多余的侧蚀。
3,调整药液体系
通过降低药液温度或改变浓度或加入添加剂,将反应机制从“质量传输控制(扩散主导)”转变为“表面反应控制”。虽然依然是各向同性,但在某些特定药液界面,侧壁的形貌会更平滑一些,减少钻污。


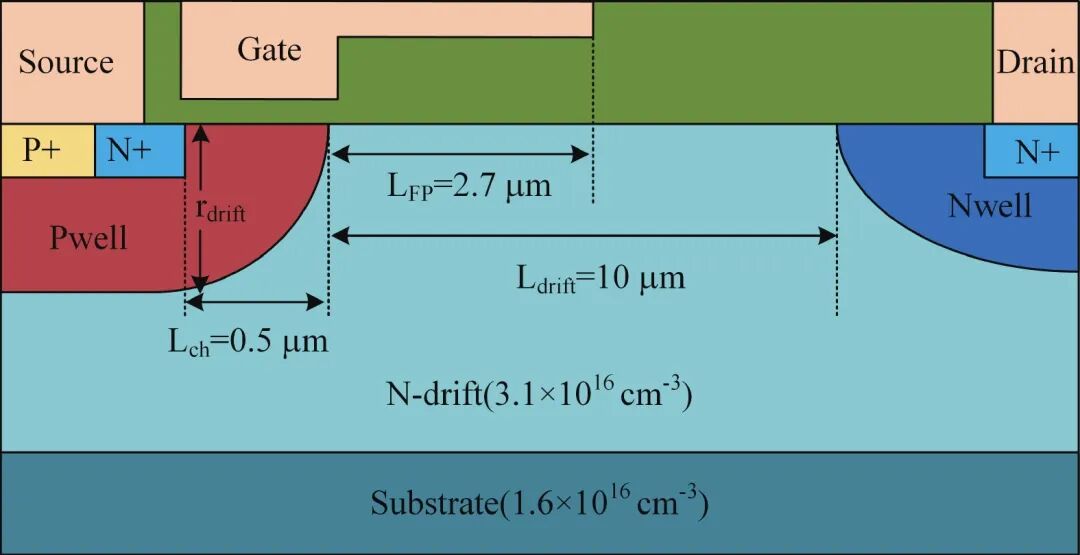










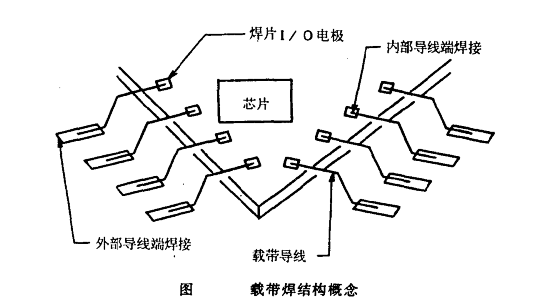


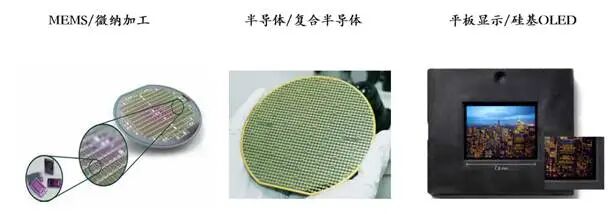

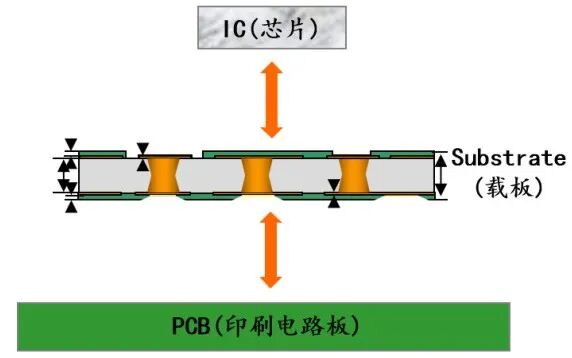
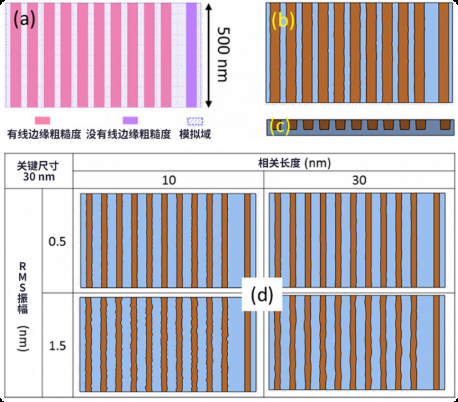
评论区
登录后即可参与讨论
立即登录