本次简单介绍芯片(IC)与封装载体(Substrate)与PCB之间最主流的几种互联方式。
正面(TOP面)连接:指芯片(IC)与封装载板(Substrate)之间的连接方式,位于整个载板的上层,是芯片内部信号与封装载体交互关键位置,用于将芯片功能引出。
背面(BOT面)连接:指封装载板(Substrate)与印刷电路板(PCB)之间的连接方式,位于载板的下层,是封装后的载板与外部电路系统对接的位置,用于最终应用终端产品上。
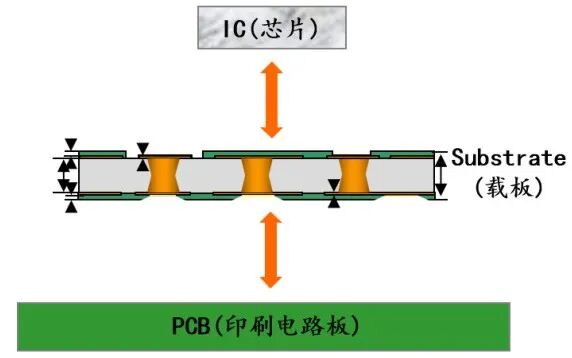
正面(TOP面)与芯片连接方式包括
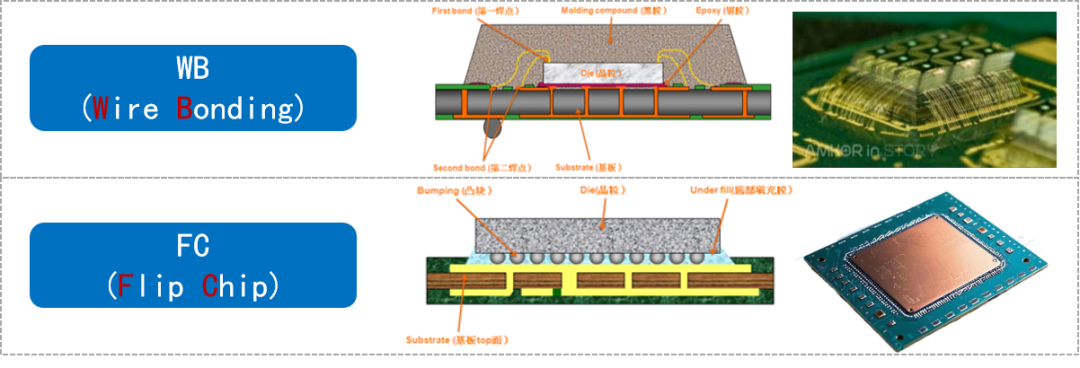
Substrate正面(TOP面)与芯片的连接方式
WB(Wire Bonding,引线键合)
技术原理:用金属细线(如金线、铜线)将芯片正面的焊盘与封装载板的引脚连接,是最传统、成熟的封装工艺。
结构特征:芯片表面凸起,金属线呈“桥接”状态连接芯片与载板。
应用场景:成本低、工艺成熟,广泛用于消费电子(如单片机、通用MCU)、中低端电源管理芯片等非超高密度场景。
FC(Flip Chip,倒装芯片)
技术原理:将芯片正面朝下倒扣在载板上,芯片表面的焊盘直接与载板上的焊盘通过凸点(Bump)互联,无金属线直接连接。
结构特征:芯片贴合载板,凸点作为中间连接介质,整体厚度更薄、占用空间更小。
应用场景:高频、高密度场景,如高端手机芯片、CPU、GPU、AI加速芯片等,能实现更小封装和更高信号传输效率。
背面(BOT面)与芯片连接方式包括
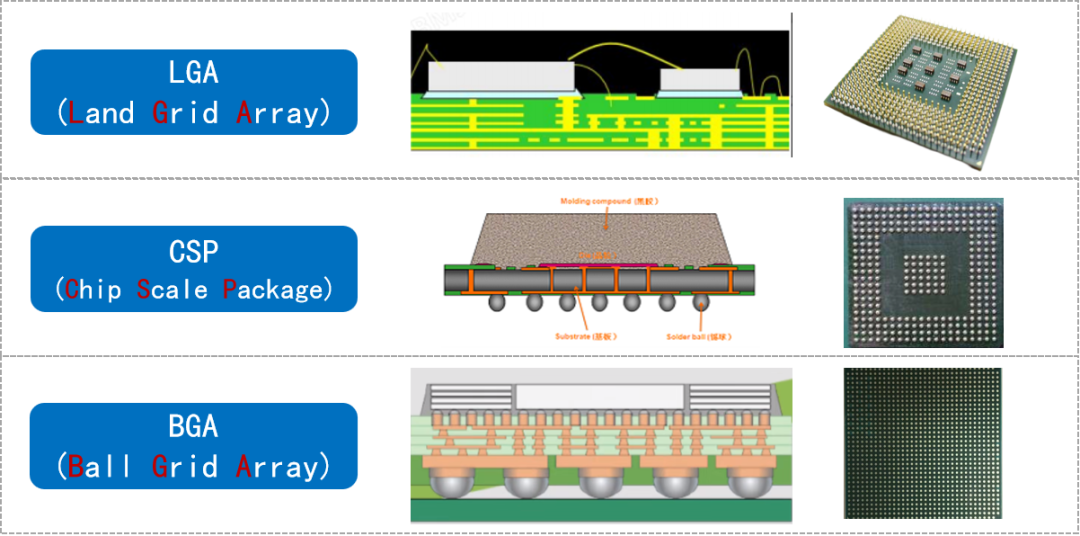
Substrate背面(BOT面)与PCB的连接方式
LGA(Land Grid Array,栅格阵列封装)
技术原理:芯片背面(BOT面)为裸露的金属焊盘阵列,直接与PCB的焊盘接触连接,无焊球,依靠物理接触与PCB导通。
结构特征:芯片底部无凸起焊球,仅为平面金属焊盘。
应用场景:对散热要求高的场景,如台式机CPU、部分高性能芯片,可直接贴合PCB散热,且拆装相对灵活。
CSP(Chip Scale Package,芯片级封装)
技术原理:封装尺寸与芯片裸片尺寸几乎一致,是极致小型化封装,通常结合WB或FC工艺实现芯片与载板的连接。
结构特征:封装体积接近芯片本身,引脚间距极小,集成度极高。
应用场景:超小型电子设备,如智能穿戴设备、微型传感器、手机摄像头模组等。
BGA(Ball Grid Array,球栅阵列封装)
技术原理:芯片背面(BOT面)布置焊球阵列,通过焊球与PCB上的焊盘焊接导通,是目前最主流的高密度封装方式之一。
结构特征:芯片底部为球形焊球阵列,连接稳固、密度高。
应用场景:高性能、高引脚数场景,如CPU、GPU、存储芯片、AI芯片、高端射频芯片等。
总之,载板如何称呼,在定义上可以先看芯片与载板怎么连(WB/FC),再看载板与PCB怎么连(LGA/CSP/BGA),最后根据特殊组合定义混合形态。
如当芯片正面(TOP面)同时存在WB和FC两种连接方式时,可称为Hybrid Substrate。这种类型的载板方案结合了两种及两种以上工艺的优势,比如部分高频信号用FC实现低延迟互联,部分通用信号用WB实现低成本连接,广泛用于高端AI芯片、异构集成封装,通过差异化适配不同信号与场景需求,实现了性能、成本与集成度的最佳平衡。











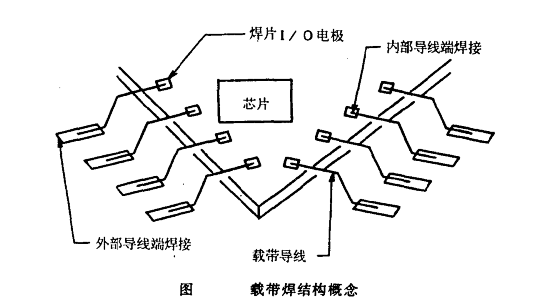


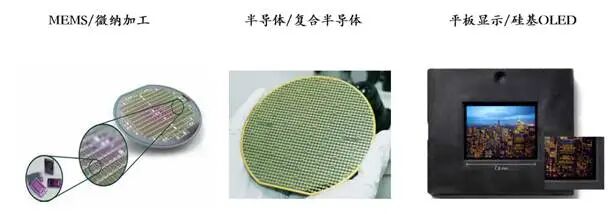

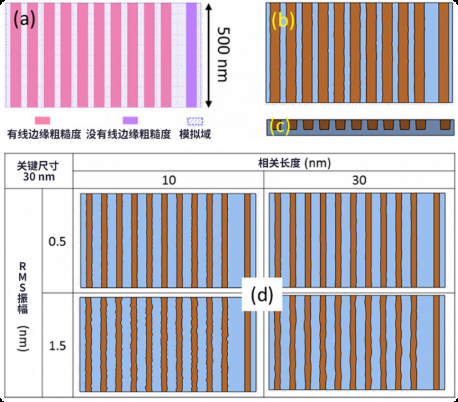
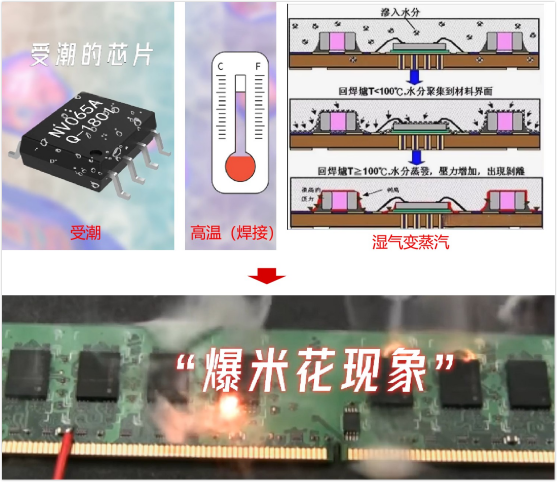
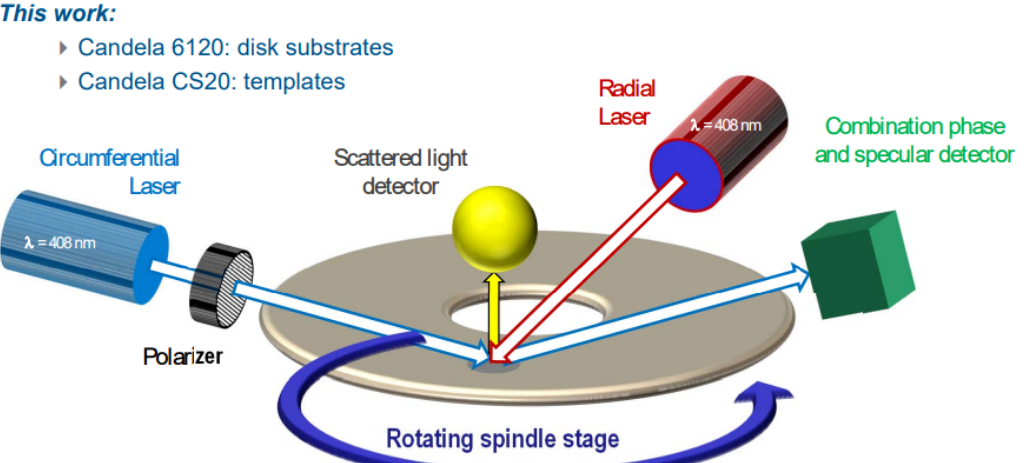
评论区
登录后即可参与讨论
立即登录