本文将介绍体微机械、各向异性刻蚀与表面微机械的工艺图谱。
体微机械工艺
体微机械工艺作为MEMS制造中历史最为悠久的微机械工艺类型,其核心在于通过选择性刻蚀去除部分衬底以形成所需微结构,该工艺深度融合了传统微电子工艺与高度专业化的微机械加工能力。在湿法化学体微加工领域,其凭借高刻蚀速率与高选择比的优势长期占据工业应用主导地位,刻蚀过程通过光刻胶图案转印后,将衬底浸入刻蚀溶液实现未保护区域的去除,其速率调控机制可分为扩散受限与反应速率受限两类——前者受反应物迁移与产物移除速率主导,可通过溶液搅动强化;后者则由表面化学反应速率决定,与溶液温度、成分及衬底掺杂浓度、晶面暴露等参数密切相关,工业实践中更倾向反应速率受限模式以保障重复性与效率。
湿法刻蚀依晶向依赖性分为各向同性与各向异性两大类。各向同性刻蚀速率与晶向无关,典型如HNO₃-HF-HC₂H₃O₂体系对硅的刻蚀,其自催化特性源于HNO₂的生成与参与,浓度提升会推动刻蚀向扩散受限模式转变,需通过强力搅动平衡横向与纵向刻蚀速率差异;掩模选择方面,氮化硅因对硅刻蚀的高选择比成为首选,远优于二氧化硅。而各向异性刻蚀则因硅晶体晶格平面原子排列密度差异及共价键遮蔽效应,呈现显著晶向依赖性——<111>方向因原子密度最大且存在三个共价键保护,刻蚀速率可较其他方向低达1000:1,该特性被广泛用于精确控制微结构形貌。
各向异性刻蚀技术通过精准调控硅晶格不同晶面的刻蚀速率差异,在体微机械工艺中实现了高精度三维结构制造与维度控制,其核心优势在于可构建自绝缘结构并实现双面工艺处理——仅暴露单侧于严苛环境,这对压力传感器等需耐受恶劣外部条件的MEMS器件封装至关重要。
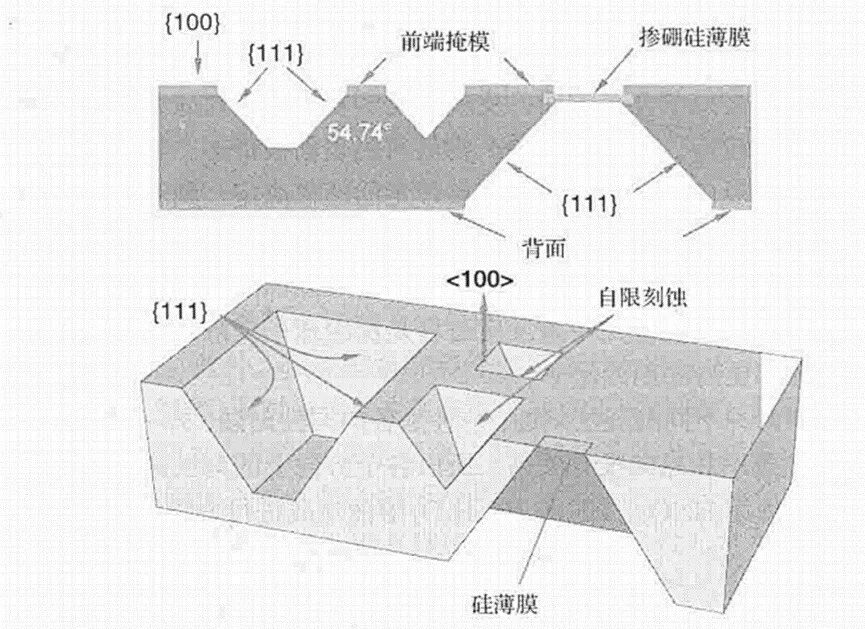
该技术历经三十余年发展,至今仍是硅基压力传感器、体微机械加速度计等主流产品的制造基石,其应用依赖于对<100>晶圆上<111>晶面低刻蚀速率特性的深度利用,如通过各向异性刻蚀在<100>晶圆上形成倒金字塔、平底梯形等特征结构,或利用底部保留的薄层直接构建压力敏感膜,这些形貌控制均源于<111>晶面与<100>晶面间高达1000:1的刻蚀速率比。
刻蚀剂选择是各向异性刻蚀的关键环节,金属碱类水性溶液(如KOH、TMAH、CsOH)因高刻蚀速率及(100)/(111)速率比优势长期占据主导地位,其中TMAH因对铝的低腐蚀性更适配预处理微电子晶圆,但其对二氧化硅掩模的高刻蚀速率需通过增厚掩模或优化工艺平衡;EDP(氯酸化乙二胺与邻苯二酚)则以更广的掩模材料兼容性(如金属钽、金等)及高(100)/(111)速率比著称,但致癌性、刻蚀过程可视化困难及残留清除难题限制其应用。掩模层需兼顾低刻蚀速率与工艺兼容性,氮化硅因在多数刻蚀剂中低刻蚀速率成为首选,热氧化二氧化硅需保证足够厚度以抵御KOH等溶液的侵蚀,而光刻胶因抗刻蚀能力不足无法直接作为各向异性刻蚀掩模。
表面微机械工艺
表面微机械工艺作为MEMS制造的核心技术之一,凭借其独特的分层构建逻辑与高精度控制能力,在微系统器件制造中占据重要地位。
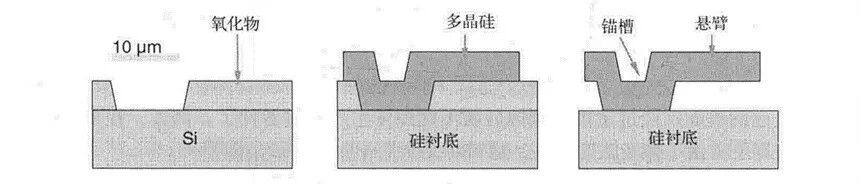
该工艺通过沉积牺牲层与结构层交替叠加,结合光刻与刻蚀工艺形成预定图案,最终通过牺牲层剥离实现可动微结构的释放,如悬臂梁、共振结构等。其核心优势在于垂直与水平方向的双重高精度控制——垂直方向依托薄膜沉积工艺的成熟度,可实现纳米级厚度精确调控;水平方向则凭借先进光刻与刻蚀技术,保障微米级甚至亚微米级图案精度。
材料选择的多样性进一步拓展了其应用场景,牺牲层可采用氧化硅、多晶硅、光刻胶或新型可降解聚合物,结构层则涵盖多晶硅、氮化硅、金属薄膜等,通过LPCVD等工艺的共形覆盖特性,可构建复杂三维微结构。然而,该工艺亦面临挑战:LPCVD薄膜的机械性能波动需通过实时测量与工艺优化校准,高残余应力需通过高温退火或应力补偿层设计缓解,而结构释放过程中的黏着效应则需借助抗黏着涂层或表面改性技术抑制。近年,表面微机械工艺持续向高可靠性、低应力方向发展,例如采用低温退火工艺减少热应力,开发自组装单分子层抗黏着技术,以及引入机器学习算法优化薄膜沉积参数,提升批次间一致性。
晶圆键合
晶圆键合作为实现多层晶圆集成的关键技术,通过直接键合、阳极键合、共晶键合、玻璃粉键合及聚合物键合等多种路径,构建三维微系统结构。
直接键合依赖晶圆表面高平整度与清洁度,经水合处理、物理接触、红外检测及高温退火后,形成与单晶硅相当的键合强度,近年通过氧等离子体预处理可实现250℃~300℃低温键合,拓展了温度敏感器件的应用场景。
阳极键合则利用硅与Pyrex 7740玻璃的热膨胀系数匹配特性,通过电场与高温协同作用实现低应力键合,成为MEMS封装的主流技术。
共晶键合借助金中间层的快速扩散特性,在较低温度下实现硅-硅键合;玻璃粉键合通过中间层熔化流动实现晶圆结合;聚合物键合则利用环氧树脂、聚酰亚胺等材料的粘弹性,在易碎晶圆处理中提供机械支撑。




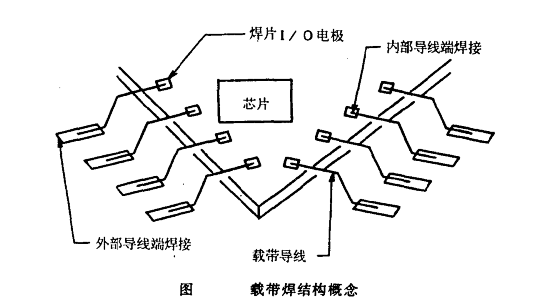









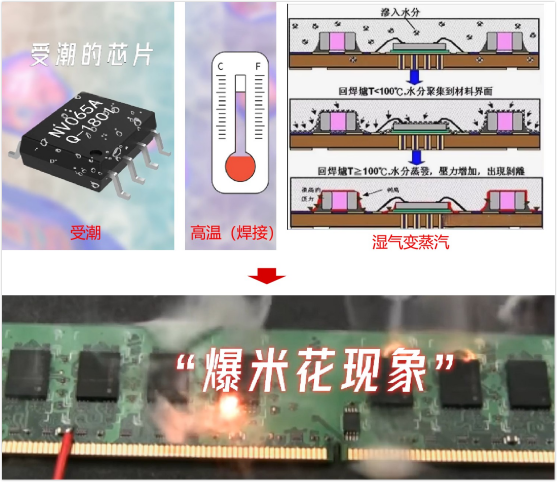
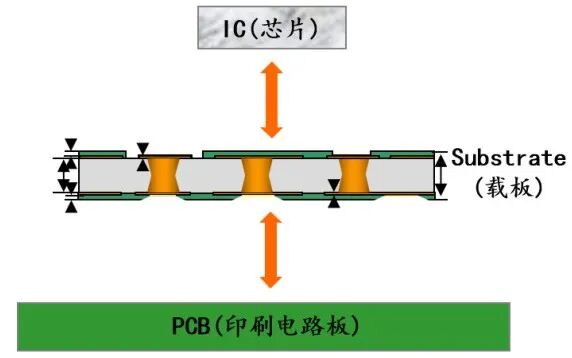
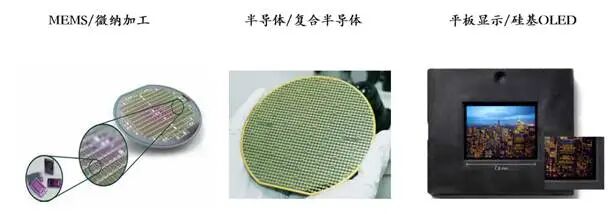

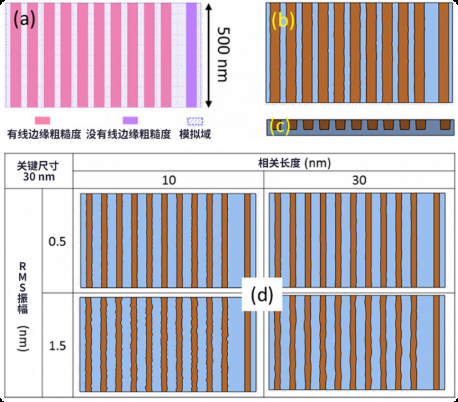

评论区
登录后即可参与讨论
立即登录