本文主要介绍单晶硅湿法刻蚀用什么做掩膜。
在单晶硅的湿法刻蚀中,选择何种材料作为掩膜(Mask),严格取决于所使用的刻蚀液的化学成分以及刻蚀的深度与时间。
产线中最常用的掩膜材料分为硬掩膜(Hard Mask)和金属掩膜,具体分类和应用条件如下:
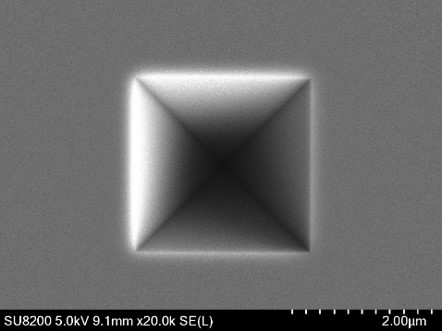
1. 氮化硅 :适用性最广的深层刻蚀掩膜
适用刻蚀液: 碱性刻蚀液(如 KOH、TMAH)和酸性刻蚀液(如 HNA)。
通过低压化学气相沉积(LPCVD)制备的氮化硅薄膜极其致密。它在热 KOH 或 TMAH 溶液中的刻蚀速率几乎为零。同时,它对含有一定浓度 HF 的酸性溶液也具有极强的耐受性。
当需要对单晶硅进行大深度、长时间的各向异性刻蚀(例如穿透几百微米厚的硅片,或加工大深度的 V 型槽和 MEMS 悬臂梁)时,氮化硅是绝对的首选掩膜。
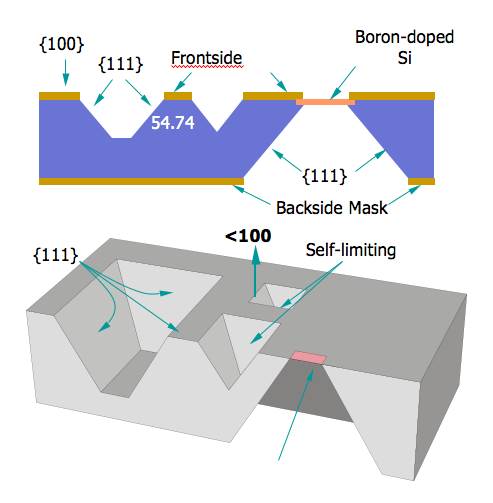
2. 二氧化硅 :适用于中浅层碱性刻蚀
适用刻蚀液: 碱性刻蚀液(优先用于 TMAH 或 EDP,有条件用于 KOH)。
热氧化生长的 SiO2 易于制备。在 TMAH 溶液中,SiO2 的刻蚀速率非常低,可以作为良好的掩膜。但在高温 KOH 溶液中,SiO2具有较快的刻蚀速率。
适用于刻蚀深度较浅的工艺,或者在 TMAH 体系中进行刻蚀。如果必须在 KOH 中进行深硅刻蚀并使用 SiO2 作为掩膜,则必须生长足够厚的氧化层,以确保在硅被刻蚀到指定深度前,掩膜层不会被完全消耗。
严禁用于 HNA 刻蚀液。HNA 中含有氢氟酸(HF),HF 会极其迅速地溶解 SiO2,导致掩膜瞬间失效。
3. 金属掩膜(如 金 Au/ 铂 Pt)
适用刻蚀液: 特殊的强碱、强酸或电化学刻蚀环境。
贵金属对绝大多数湿法化学试剂呈化学惰性。为了解决金与单晶硅附着力差的问题,通常需要先溅射一层极薄的铬(Cr)或钛(Ti)作为粘合层,然后再沉积金。
当常规的 SiO2 或 Si3N4掩膜无法满足极其苛刻的刻蚀条件,或工艺流程中无法进行高温沉积(CVD)氧化物/氮化物时使用。
4. 关于光刻胶的局限性
光刻胶通常不能直接作为单晶硅主刻蚀工艺的掩膜。
在碱性刻蚀液中:高温 KOH 或 TMAH 会迅速引起光刻胶发生皂化反应、溶胀并大面积剥离。
在酸性刻蚀液中:HNA 刻蚀液具有强氧化性,会直接破坏光刻胶的有机结构。





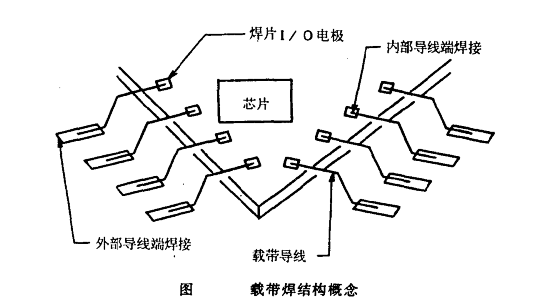









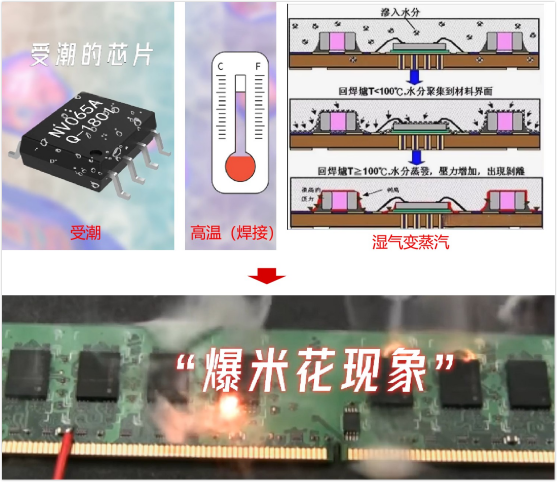
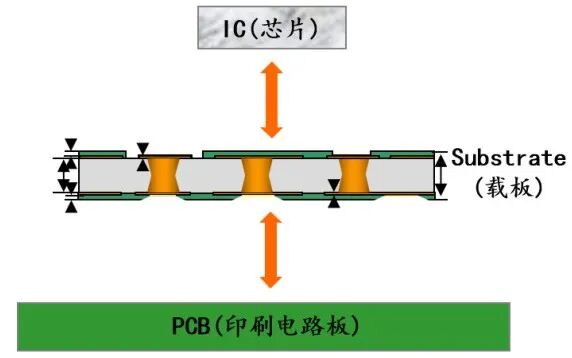
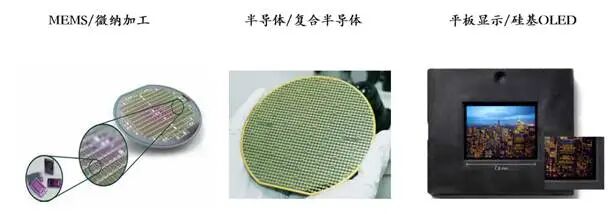

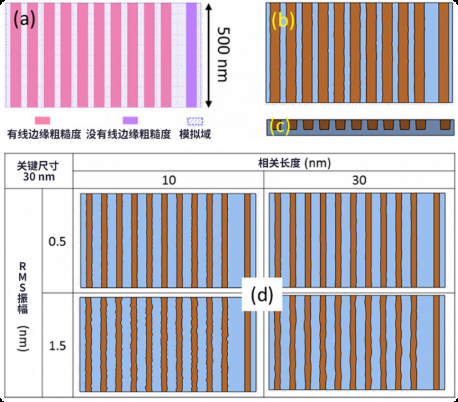
评论区
登录后即可参与讨论
立即登录