本文介绍了固液互扩散键合的基本原理、材料体系和优势。
固液互扩散键合基本原理?
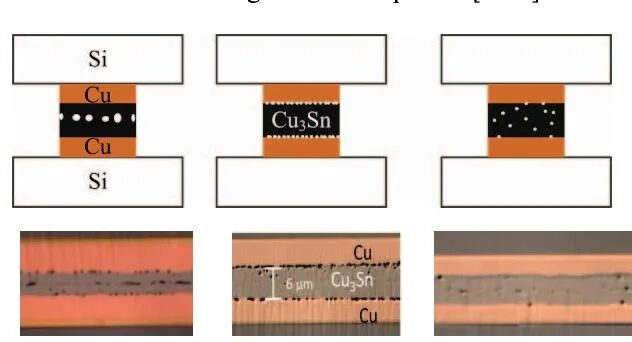
SLID 全称 Solid-Liquid Interdiffusion Bonding,中文也叫瞬态液相键合,核心思路是:
用低熔点金属在较低温度下液化,与高熔点金属互扩散形成金属间化合物,而这个化合物的熔点远高于最初的键合温度。
材料体系?
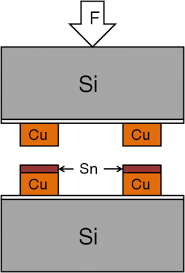
低熔点金属:常用的有锡 (Sn) 和铟 (In)。
高熔点金属:主要使用铜 (Cu)、金 (Au) 和银 (Ag)。
主流选择:虽然有 Au-Sn 和 Ag-Sn 等组合,但在科学研究和工业应用中,Cu-Sn 系统因其成本效益高且具备良好的迁移特性,成为了重点关注对象。
以 Cu-Sn 体系为例(最主流)
| 步骤 | 发生的事 |
| 升温至 ~232°C(Sn熔点) | Sn层液化 | | 施加键合压力 | 两片晶圆全面积接触 | | 液态Sn与固态Cu互扩散 | 界面形成 η相(Cu₆Sn₅)金属间化合物 | | 降温后 | 界面固化,Sn已消耗完,剩下Cu₃Sn等高熔点相 |
最终界面的熔点可达 415°C 以上,但键合温度只需要 约250–300°C,这就是"瞬态液相"的价值所在。
SLID Bonding优势?
一、键合+导电+导热一体化,金属间化合物界面同时具备机械连接、电气互连、散热通道三重功能,非常适合3D集成叠层封装。
二、再流焊兼容性,键合后界面熔点高于标准回流焊温度(~260°C),封装好的器件还可以再过回流焊炉,不会脱键,这是其他低温键合做不到的。
三、成本效率高,Cu-Sn体系相比Au-Sn、Ag-Sn便宜很多,而且Cu是晶圆厂标准金属化材料,工艺兼容性好。
不代表中国科学院半导体所立场
责编:猫薄荷








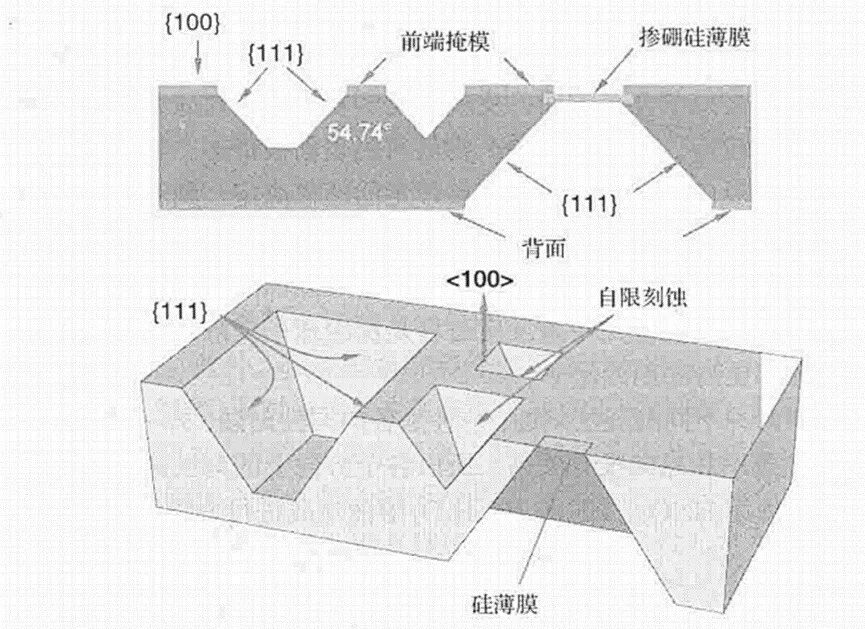

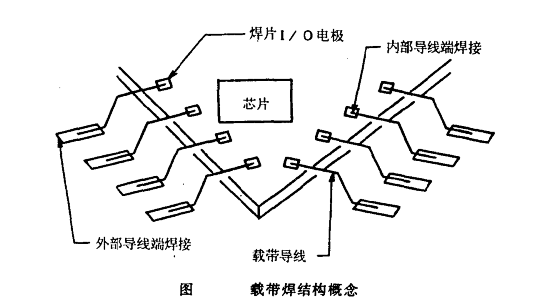


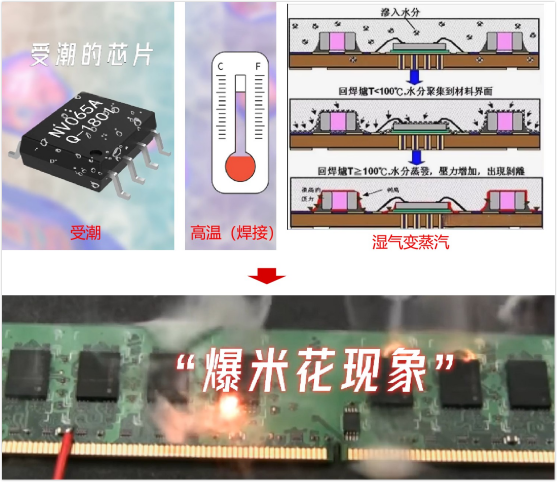
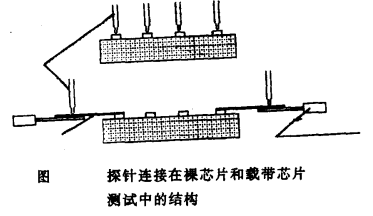




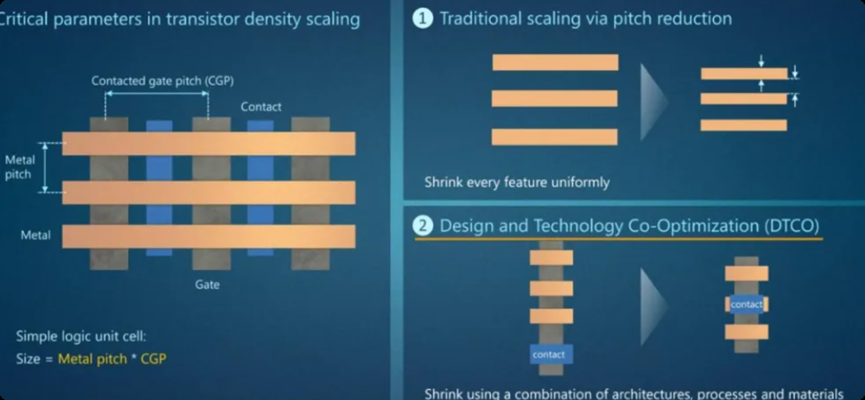
评论区
登录后即可参与讨论
立即登录