本文介绍了硅片的热氧工艺与退火。
为什么要给硅片“氧化”?
纯硅本身并不绝缘。要让电流在该走的时候走、不该走的时候停,必须在特定区域形成绝缘层。二氧化硅恰好是完美的天然选择:它与硅的晶格匹配良好、击穿强度高、化学性质稳定。氧化层在芯片中扮演三种角色:
-
栅介质:MOS晶体管中控制沟道开闭的核心绝缘层,厚度可薄至1-2纳米(仅几层原子)。
-
隔离层:像“围墙”一样隔开不同器件,防止电流串扰,典型例子是场氧化层和浅槽隔离。
-
掩膜层:在刻蚀或离子注入时,保护下方硅不被改变。

根据氧化反应所使用的气体,热氧化法可分为干氧化(Dry Oxidation)和湿氧化(WetOxidation)。
干氧氧化: Si+O2-->SiO2
湿氧氧化:Si+ H2O + O2-->SiO2 + H2
水汽氧化(湿氧):Si + H2O -->SiO2 + H2
干氧化只使用纯氧气(O2),所以氧化膜的生长速度较慢,主要用于形成薄膜,且可形成具有良好导电性的氧化物。湿氧化同时使用氧气(O2)和高溶解性的水蒸气(H2O)。所以,氧化膜生长速度快,会形成较厚的膜。但与干氧化相比,湿氧化形成的氧化层密度低。通常,在相同温度和时间下,通过湿氧化获得的氧化膜比使用干氧化获得的氧化膜要厚大约5至10倍。

实际应用中的常见问题
- 为何不直接用干氧生长厚氧化层?
因为干氧生长后期受扩散控制,生长极慢,且过长的热过程会导致杂质再分布、影响器件性能。湿氧速度快、成本低,适合厚膜。
- 薄栅氧化层也能用湿氧吗?
不能。湿氧生长的氧化层含氢缺陷多、击穿电压低,无法满足栅介质对可靠性的严苛要求。
- 快速热氧化(RTO)与常规炉管氧化有何区别?
RTO单片刻蚀升降温,热预算极低,能生长1-5 nm的超薄氧化层,且界面过渡区更陡峭;常规炉管批量处理,适合50 nm以上的厚氧化层。

什么是退火?
退火本质上是一种可控的热处理过程:将硅片加热到特定温度(通常在600℃至1200℃之间),保持一定时间,再以适当速度冷却。它不改变硅片的宏观形状,却能“修复”和“唤醒”内部的微观世界。

退火的四大核心作用
1. 激活掺杂剂——让杂质原子“归位”
离子注入时,高能掺杂原子(如硼、磷、砷)像子弹一样打入硅晶格。多数原子“卡”在晶格间隙或随机位置,处于 “电休眠”状态——它们不能提供自由电子或空穴,也就无法改变硅的导电类型。
退火提供足够的热能,让这些间隙原子获得迁移能力,找到硅晶格中被撞出的空位并替换进去,从此成为晶格的一部分。这一过程叫做“替位激活”。激活后的掺杂剂才能真正贡献载流子,形成PN结或导电通道。没有退火,注入的杂质只是物理存在于硅中,对电性能几无贡献。
2. 修复晶格损伤——从“弹坑”恢复到“镜面”
离子注入的暴力过程会把硅原子从晶格上撞离,产生大量空位、间隙原子,甚至使表面几纳米到几十纳米变成非晶层。这样的晶格充满缺陷,载流子迁移率极低,漏电流巨大。
退火时,热能促使硅原子振动、扩散、重排。非晶区域会通过固相外延方式重新结晶,几乎完美地恢复成单晶结构。就像把布满弹坑的路面重新碾平铺好,恢复平坦和强度。
3. 消除内应力——防止硅片翘曲
硅片在高温氧化、薄膜沉积、快速升降温度中都会积累热应力和机械应力。这些应力若不释放,会导致硅片弯曲、出现滑移线,甚至使后续光刻对焦失败或器件断裂。退火通过恰当的温控曲线,让晶格原子“松弛”下来,应力得以均匀释放。
4. 减少有害缺陷,改善电学可靠性
某些工艺步骤会引入深能级杂质(如重金属铁、铜),它们会在禁带中形成复合中心,大幅降低少子寿命,增加漏电流。高温退火可以促使这些杂质原子向硅片内部扩散并被表面吸除层捕获,从而净化有源区。对于太阳能电池和探测器等对漏电敏感的器件,这一步尤其关键。

退火方式
退火方式的选择:炉管 vs 快速热退火 vs 激光
不同的退火方式,决定了芯片最终的性能边界。

退火在芯片制造流程中的位置
以一颗典型的CMOS处理器为例:
-
浅沟槽隔离后 → 退火(致密化氧化物)
-
阱注入 → 高温长时间炉管退火(需要较深结,同时修复深部损伤)
-
源/漏延伸区注入 → 快速热退火(需要极浅结,防止短沟道效应)
-
源/漏重掺杂注入 → 快速热退火(激活高浓度杂质)
-
金属硅化物形成 → 较低温度退火(使镍或钛与硅反应)
-
后金属化介质退火 → 400℃左右(消除后续工艺应力,改善接触)
每一步的温度和时间都需要精密权衡,因为“热预算”是有限的。温度越高、时间越长,掺杂原子扩散越多,这会破坏已经做好的纳米尺度结构。








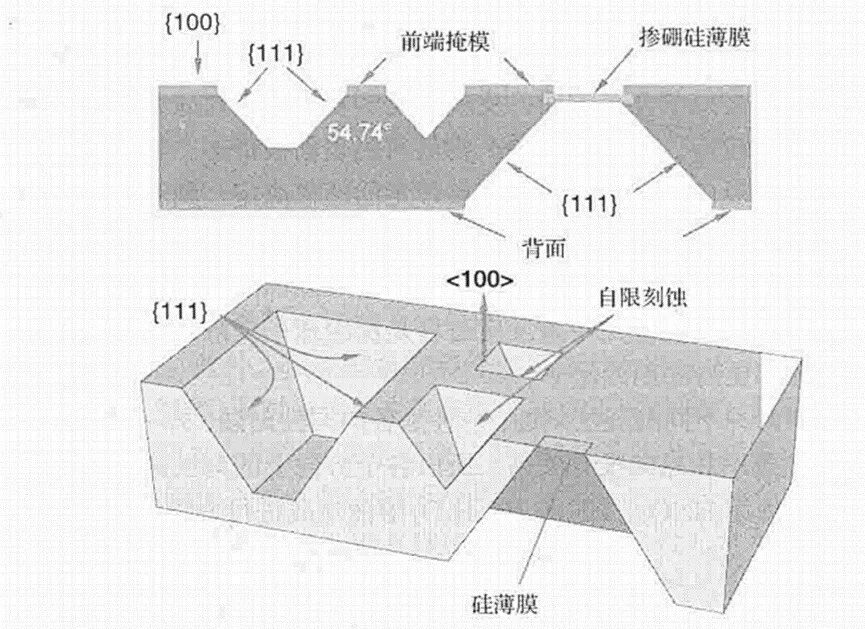

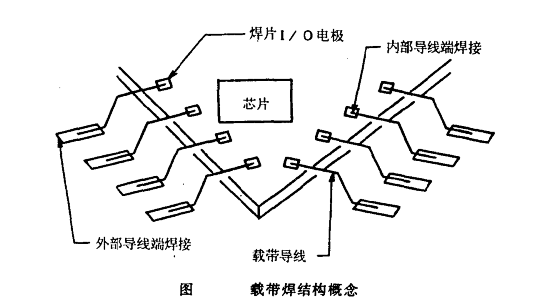


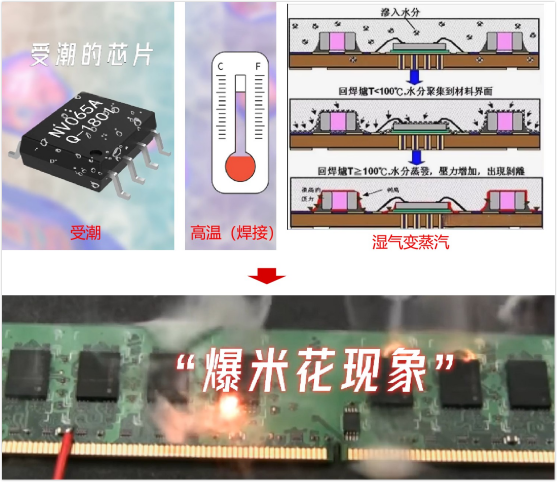
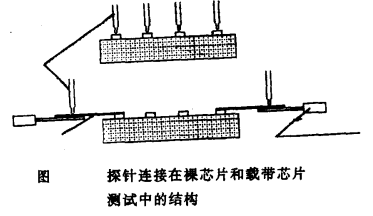




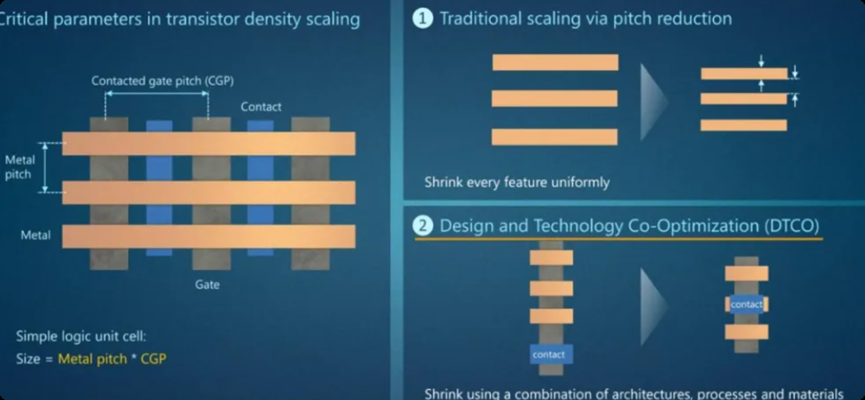
评论区
登录后即可参与讨论
立即登录